
1 Introducción
En el ensamblaje de la placa de circuito impreso, primero se imprime la pasta de soldadura en la almohadilla de soldadura de la placa, y luego se fijan los diversos componentes electrónicos. Finalmente, tras el horno de reflujo, se funden las perlas de estaño de la pasta de soldadura y se sueldan todos los componentes electrónicos y la almohadilla de soldadura de la placa para completar el ensamblaje de los submódulos eléctricos. La tecnología de montaje superficial (SMT) se utiliza cada vez más en productos de encapsulado de alta densidad, como encapsulados a nivel de sistema (SIP), dispositivos de matriz de bolas (BGA) y dispositivos de chip desnudo de alimentación, encapsulados cuadrados planos sin pines (QFN).
Debido a las características del proceso y los materiales de soldadura con pasta de soldadura, después de la soldadura por reflujo de estos dispositivos de gran superficie de soldadura, habrá agujeros en el área de soldadura de soldadura, lo que afectará las propiedades eléctricas, térmicas y mecánicas del rendimiento del producto e incluso conducirá a fallas del producto, por lo tanto, mejorar la cavidad de soldadura por reflujo de pasta de soldadura se ha convertido en un proceso y un problema técnico que debe resolverse, algunos investigadores han analizado y estudiado las causas de la cavidad de soldadura de bola de soldadura BGA y han proporcionado soluciones de mejora, el área de soldadura del proceso de soldadura por reflujo de pasta de soldadura convencional de QFN mayor a 10 mm2 o el área de soldadura mayor a 6 mm2 es deficiente en la solución de chip desnudo.
Utilice la soldadura de preforma y la soldadura en horno de reflujo al vacío para mejorar el orificio de soldadura. La soldadura prefabricada requiere equipo especial para el punto de fusión. Por ejemplo, el chip se desvía e inclina considerablemente al colocarlo directamente sobre la soldadura prefabricada. Si el chip de montaje de fundente se refluye y luego se refluye, el proceso se incrementa en dos reflujos, y el costo de la soldadura prefabricada y el material de fundente es mucho mayor que el de la pasta de soldadura.
Los equipos de reflujo al vacío son más costosos, la capacidad de vacío de la cámara de vacío independiente es muy baja, su rentabilidad es baja y el problema de las salpicaduras de estaño es grave, un factor importante en la aplicación de productos de alta densidad y paso pequeño. En este artículo, basado en el proceso convencional de soldadura por reflujo con pasta de soldadura, se desarrolla e introduce un nuevo proceso de soldadura por reflujo secundario para mejorar la cavidad de soldadura y solucionar los problemas de adhesión y agrietamiento del sello plástico causados por la cavidad de soldadura.
2 Cavidad de soldadura por reflujo para impresión de pasta de soldadura y mecanismo de producción
2.1 Cavidad de soldadura
Tras la soldadura por reflujo, el producto se analizó con rayos X. Se observó que los agujeros en la zona de soldadura, de color más claro, se debían a una cantidad insuficiente de soldadura en la capa de soldadura, como se muestra en la Figura 1.
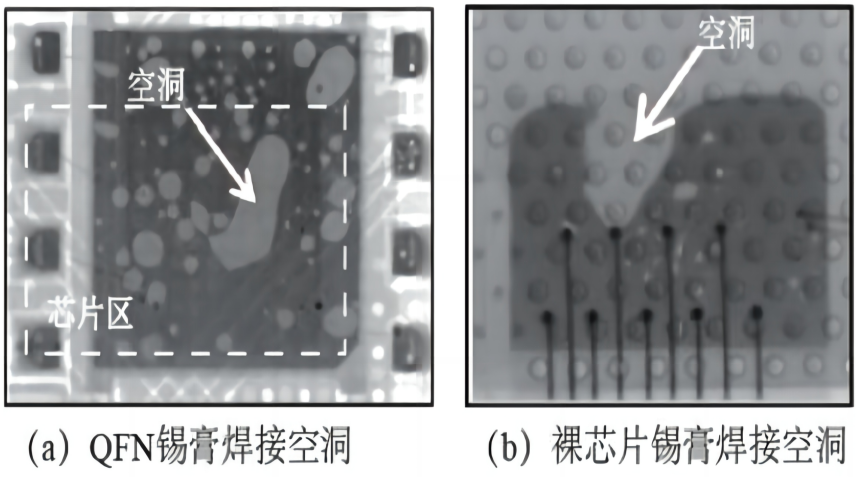
Detección de rayos X del orificio de la burbuja
2.2 Mecanismo de formación de la cavidad de soldadura
Tomando como ejemplo la pasta de soldadura sAC305, su composición y función principales se muestran en la Tabla 1. El fundente y las perlas de estaño se unen formando una pasta. La relación en peso entre la soldadura de estaño y el fundente es de aproximadamente 9:1, y la relación en volumen es de aproximadamente 1:1.

Tras imprimir y montar la pasta de soldadura con diversos componentes electrónicos, esta pasa por cuatro etapas: precalentamiento, activación, reflujo y enfriamiento al pasar por el horno de reflujo. El estado de la pasta de soldadura varía según la temperatura en cada etapa, como se muestra en la Figura 2.
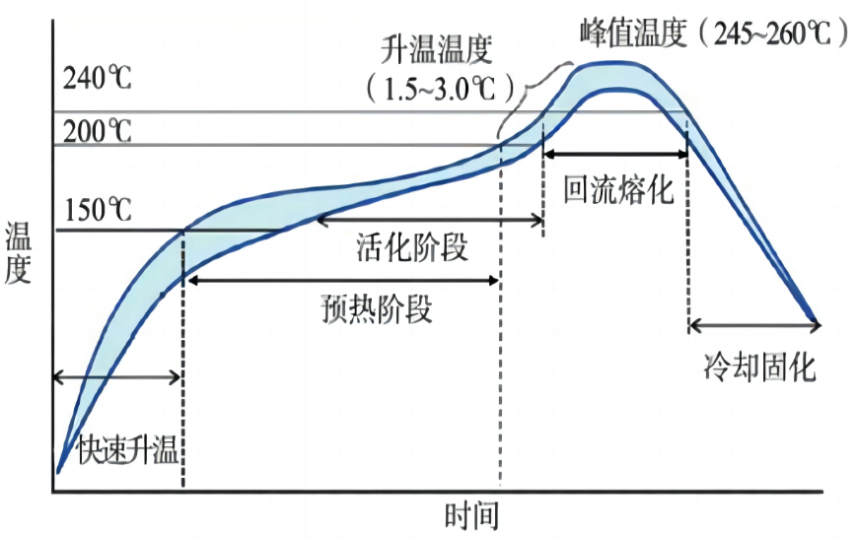
Referencia de perfil para cada área de soldadura por reflujo
En la etapa de precalentamiento y activación, los componentes volátiles del fundente en la pasta de soldadura se volatilizarán en gas al calentarse. Al mismo tiempo, se producirán gases cuando se elimine el óxido en la superficie de la capa de soldadura. Algunos de estos gases se volatilizarán y dejarán la pasta de soldadura, y las perlas de soldadura se condensarán fuertemente debido a la volatilización del fundente. En la etapa de reflujo, el fundente restante en la pasta de soldadura se evaporará rápidamente, las perlas de estaño se fundirán, una pequeña cantidad de gas volátil del fundente y la mayor parte del aire entre las perlas de estaño no se dispersarán a tiempo, y los residuos en el estaño fundido y bajo la tensión del estaño fundido son una estructura de sándwich de hamburguesa y son atrapados por la almohadilla de soldadura de la placa de circuito y los componentes electrónicos, y el gas envuelto en el estaño líquido es difícil de escapar solo por la flotabilidad ascendente. El tiempo de fusión superior es muy corto. Cuando el estaño fundido se enfría y se convierte en estaño sólido, aparecen poros en la capa de soldadura y se forman orificios de soldadura, como se muestra en la Figura 3.
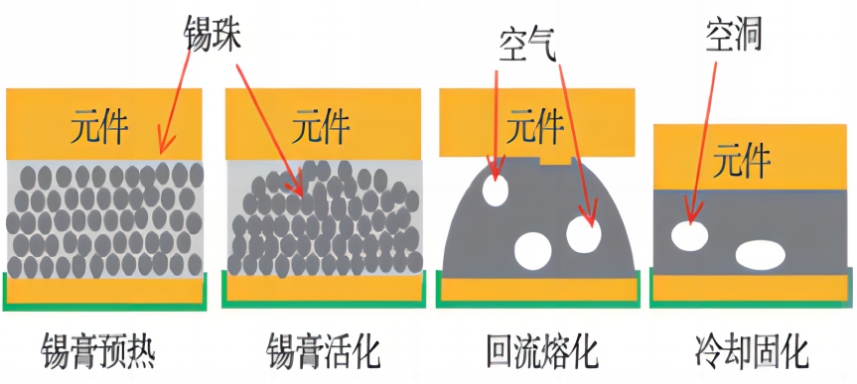
Diagrama esquemático del vacío generado por la soldadura por reflujo de pasta de soldadura
La causa principal de la cavidad de soldadura es que el aire o gas volátil envuelto en la pasta de soldadura después de fundirse no se descarga completamente. Los factores que influyen incluyen el material de la pasta de soldadura, la forma de impresión de la pasta de soldadura, la cantidad de impresión de la pasta de soldadura, la temperatura de reflujo, el tiempo de reflujo, el tamaño de la soldadura, la estructura, etc.
3. Verificación de los factores que influyen en la impresión de orificios de soldadura por reflujo con pasta de soldadura.
Se utilizaron pruebas QFN y de chip desnudo para confirmar las principales causas de los huecos de soldadura por reflujo y para encontrar maneras de mejorar los huecos de soldadura por reflujo impresos por pasta de soldadura. El perfil del producto de soldadura por reflujo con pasta de soldadura QFN y de chip desnudo se muestra en la Figura 4. El tamaño de la superficie de soldadura QFN es de 4,4 mm x 4,1 mm, la superficie de soldadura es una capa estañada (100 % estaño puro); el tamaño de la soldadura del chip desnudo es de 3,0 mm x 2,3 mm, la capa de soldadura es una capa bimetálica de níquel-vanadio pulverizada y la capa superficial es de vanadio. La almohadilla de soldadura del sustrato fue de níquel-paladio por inmersión en oro sin corriente, con un espesor de 0,4 μm/0,06 μm/0,04 μm. Se utilizó pasta de soldadura SAC305, el equipo de impresión de pasta de soldadura es DEK Horizon APix, el equipo de horno de reflujo es BTUpyramax150N y el equipo de rayos X es DAGExD7500VR.
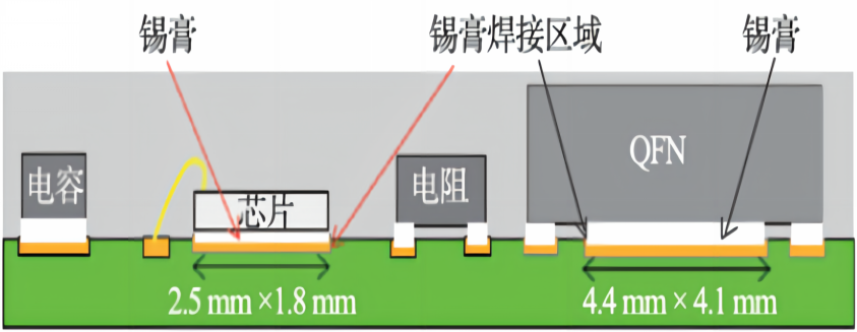
Dibujos de soldadura de chip desnudo y QFN
Para facilitar la comparación de los resultados de las pruebas, se realizó soldadura por reflujo en las condiciones de la Tabla 2.

Tabla de condiciones de soldadura por reflujo
Después de completar el montaje de la superficie y la soldadura por reflujo, se detectó la capa de soldadura mediante rayos X y se encontró que había grandes agujeros en la capa de soldadura en la parte inferior del QFN y el chip desnudo, como se muestra en la Figura 5.
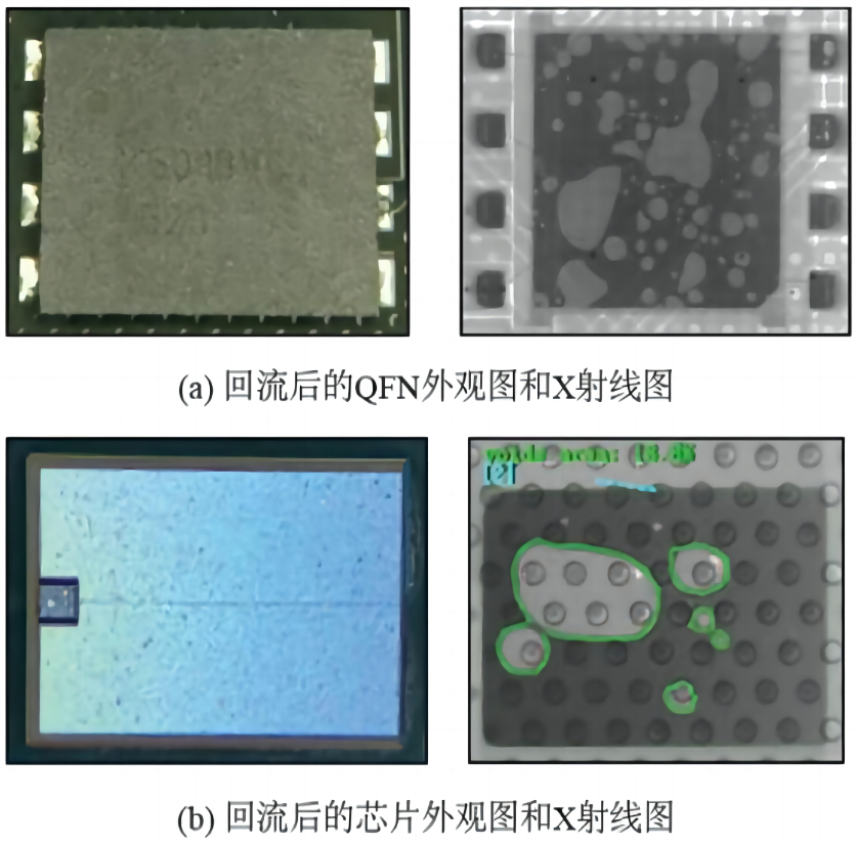
Holograma QFN y chip (rayos X)
Dado que el tamaño del cordón de estaño, el espesor de la malla de acero, la tasa de área de apertura, la forma de la malla de acero, el tiempo de reflujo y la temperatura máxima del horno afectan los huecos en la soldadura por reflujo, existen numerosos factores que influyen y que se verificarán directamente mediante la prueba DOE, y el número de grupos experimentales será excesivo. Es necesario analizar y determinar rápidamente los principales factores de influencia mediante la prueba de comparación de correlación, y posteriormente optimizarlos aún más mediante la prueba DOE.
3.1 Dimensiones de los orificios de soldadura y de los cordones de pasta de soldadura
En la prueba de pasta de soldadura SAC305 tipo 3 (tamaño de grano: 25-45 μm), las demás condiciones se mantuvieron sin cambios. Tras el reflujo, se midieron los agujeros en la capa de soldadura y se compararon con los de la pasta de soldadura tipo 4. Se observó que los agujeros en la capa de soldadura no presentaban diferencias significativas entre los dos tipos de pasta de soldadura, lo que indica que la pasta de soldadura con diferente tamaño de grano no tenía una influencia evidente en los agujeros, lo cual no era un factor determinante, como se muestra en la figura 6.

Comparación de agujeros de polvo de estaño metálico con diferentes tamaños de partículas
3.2 Espesor de la cavidad de soldadura y malla de acero impresa
Tras el reflujo, se midió el área de la cavidad de la capa soldada con una malla de acero impresa de 50 μm, 100 μm y 125 μm de espesor, manteniendo las demás condiciones. Se observó que el efecto de diferentes espesores de malla de acero (pasta de soldadura) sobre el QFN se comparó con el de la malla de acero impresa de 75 μm. A medida que aumenta el espesor de la malla de acero, el área de la cavidad disminuye gradualmente. Tras alcanzar un cierto espesor (100 μm), el área de la cavidad se revierte y comienza a aumentar con el aumento del espesor de la malla de acero, como se muestra en la Figura 7.
Esto demuestra que al aumentar la cantidad de pasta de soldadura, el estaño líquido con reflujo queda cubierto por el chip, y la salida de aire residual solo se estrecha en cuatro lados. Al variar la cantidad de pasta de soldadura, la salida de aire residual también aumenta, y la explosión instantánea de aire envuelto en estaño líquido o el escape de gas volátil de estaño líquido provoca salpicaduras de estaño líquido alrededor del QFN y el chip.
La prueba encontró que con el aumento del espesor de la malla de acero, la explosión de burbujas causada por el escape de aire o gas volátil también aumentará, y la probabilidad de que el estaño salpique alrededor del QFN y el chip también aumentará correspondientemente.

Comparación de agujeros en mallas de acero de diferentes espesores
3.3 Relación del área de la cavidad de soldadura y la abertura de la malla de acero
Se probó la malla de acero impresa con una tasa de apertura del 100%, 90% y 80%, y las demás condiciones se mantuvieron sin cambios. Tras el reflujo, se midió el área de la cavidad de la capa soldada y se comparó con la malla de acero impresa con una tasa de apertura del 100%. Se observó que no hubo diferencias significativas en la cavidad de la capa soldada en las condiciones de tasa de apertura del 100%, 90% y 80%, como se muestra en la Figura 8.

Comparación de cavidades de diferentes áreas de apertura de diferentes mallas de acero
3.4 Cavidad soldada y forma de malla de acero impresa
En la prueba de forma de impresión de la pasta de soldadura de la tira b y la rejilla inclinada c, las demás condiciones se mantuvieron sin cambios. Tras el reflujo, se midió el área de la cavidad de la capa de soldadura y se comparó con la forma de impresión de la rejilla a. Se observó que no existe diferencia significativa en la cavidad de la capa de soldadura en las condiciones de la rejilla, la tira y la rejilla inclinada, como se muestra en la Figura 9.
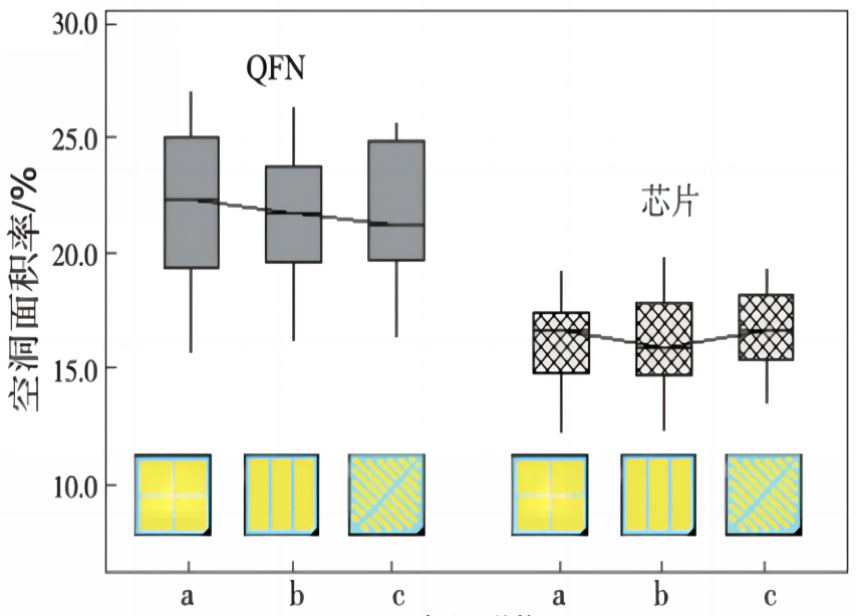
Comparación de agujeros en diferentes modos de apertura de malla de acero
3.5 Cavidad de soldadura y tiempo de reflujo
Tras una prueba de reflujo prolongado (70 s, 80 s, 90 s), con las demás condiciones sin cambios, se midió el orificio en la capa de soldadura tras el reflujo y, en comparación con el tiempo de reflujo de 60 s, se observó que, al aumentar el tiempo de reflujo, el área del orificio disminuía, pero la amplitud de la reducción disminuía gradualmente con el aumento del tiempo, como se muestra en la Figura 10. Esto demuestra que, si el tiempo de reflujo es insuficiente, aumentarlo favorece el desbordamiento completo del aire envuelto en el estaño líquido fundido. Sin embargo, una vez que el tiempo de reflujo aumenta hasta cierto punto, dificulta el desbordamiento. El tiempo de reflujo es uno de los factores que afectan a la cavidad de soldadura.

Comparación nula de diferentes duraciones de tiempo de reflujo
3.6 Cavidad de soldadura y temperatura máxima del horno
Con una prueba de temperatura máxima del horno de 240 ℃ y 250 ℃ y otras condiciones sin cambios, se midió el área de la cavidad de la capa soldada después del reflujo y, en comparación con la temperatura máxima del horno de 260 ℃, se encontró que, bajo diferentes condiciones de temperatura máxima del horno, la cavidad de la capa soldada de QFN y el chip no cambió significativamente, como se muestra en la Figura 11. Muestra que la diferente temperatura máxima del horno no tiene un efecto obvio en QFN y el agujero en la capa de soldadura del chip, que no es un factor influyente.

Comparación nula de diferentes temperaturas máximas
Las pruebas anteriores indican que los factores significativos que afectan la cavidad de la capa de soldadura de QFN y el chip son el tiempo de reflujo y el espesor de la malla de acero.
4. Mejora de la cavidad de soldadura por reflujo con impresión de pasta de soldadura.
Prueba 4.1DOE para mejorar la cavidad de soldadura
El agujero en la capa de soldadura de QFN y chip se mejoró al encontrar el valor óptimo de los principales factores de influencia (tiempo de reflujo y espesor de la malla de acero). La pasta de soldadura fue SAC305 tipo 4, la forma de la malla de acero fue tipo rejilla (grado de apertura del 100%), la temperatura máxima del horno fue de 260 ℃ y otras condiciones de prueba fueron las mismas que las del equipo de prueba. La prueba DOE y los resultados se muestran en la Tabla 3. Las influencias del espesor de la malla de acero y el tiempo de reflujo en los agujeros de soldadura de QFN y chip se muestran en la Figura 12. A través del análisis de interacción de los principales factores de influencia, se encuentra que el uso de un espesor de malla de acero de 100 μm y un tiempo de reflujo de 80 s puede reducir significativamente la cavidad de soldadura de QFN y chip. La tasa de cavidad de soldadura de QFN se reduce del máximo 27.8% al 16.1%, y la tasa de cavidad de soldadura de chip se reduce del máximo 20.5% al 14.5%.
En la prueba, se fabricaron 1000 productos en condiciones óptimas (malla de acero de 100 μm de espesor y 80 s de tiempo de reflujo). Se midió aleatoriamente la tasa de cavidad de soldadura de 100 QFN y viruta. La tasa promedio de cavidad de soldadura de QFN fue del 16,4 % y la de viruta del 14,7 %. La tasa de cavidad de soldadura de la viruta y la viruta se redujo significativamente.

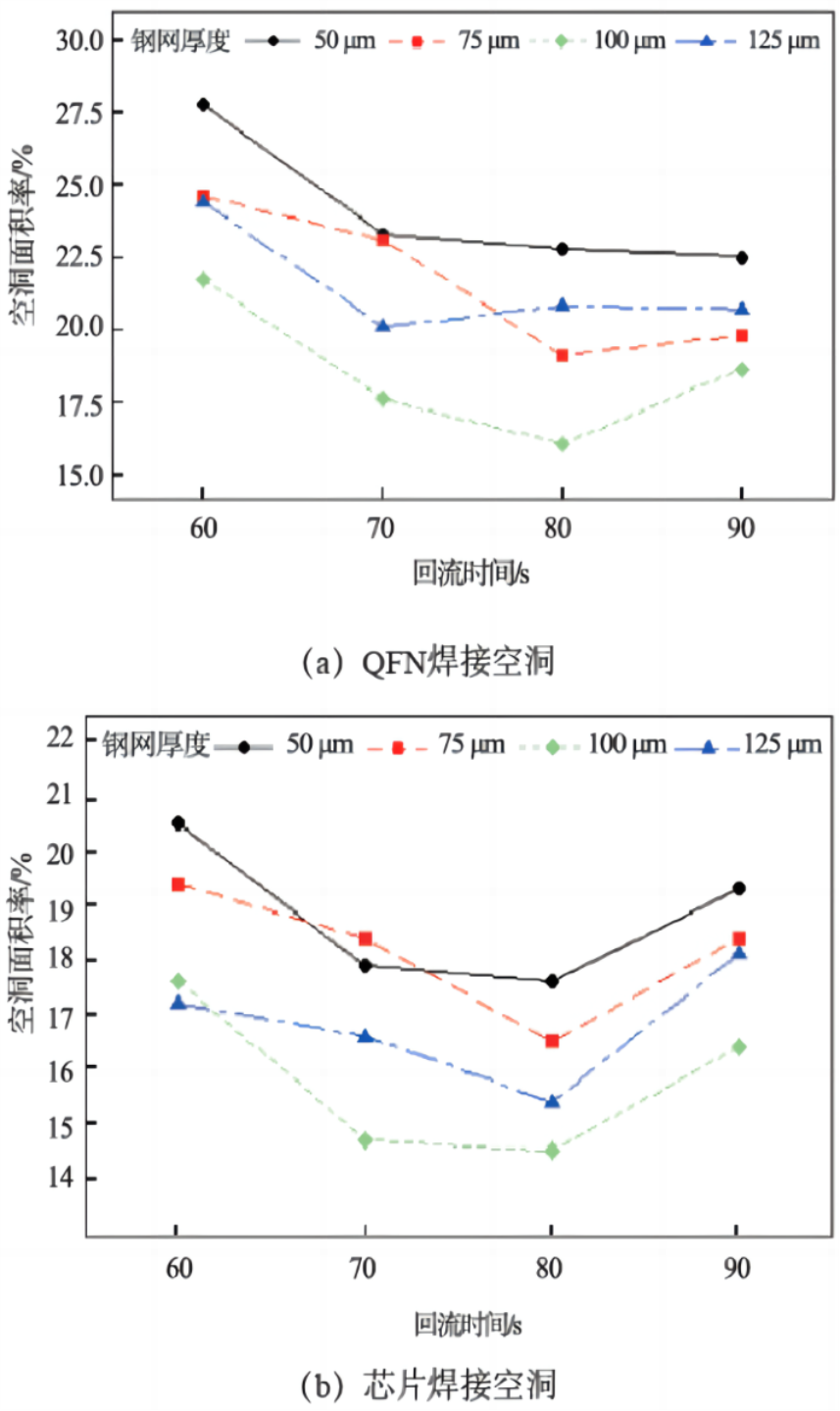
4.2 El nuevo proceso mejora la cavidad de soldadura
La situación real de producción y las pruebas demuestran que cuando el área de la cavidad de soldadura en la parte inferior del chip es inferior al 10%, no se producen grietas en la cavidad del chip durante la unión y el moldeo de los conductores. Los parámetros del proceso optimizados por el DOE no cumplen con los requisitos de análisis y eliminación de los agujeros en la soldadura por reflujo con pasta de soldadura convencional, por lo que es necesario reducir aún más el área de la cavidad de soldadura del chip.
Dado que el chip cubierto por la soldadura impide que el gas de la misma escape, la tasa de agujeros en la parte inferior del chip se reduce aún más al eliminar o reducir el gas recubierto por la soldadura. Se adopta un nuevo proceso de soldadura por reflujo con dos impresiones de pasta de soldadura: una impresión de pasta de soldadura, otra de reflujo sin cubrir QFN y un chip desnudo que descarga el gas de la soldadura. El proceso específico de impresión secundaria de pasta de soldadura, parche y reflujo secundario se muestra en la Figura 13.
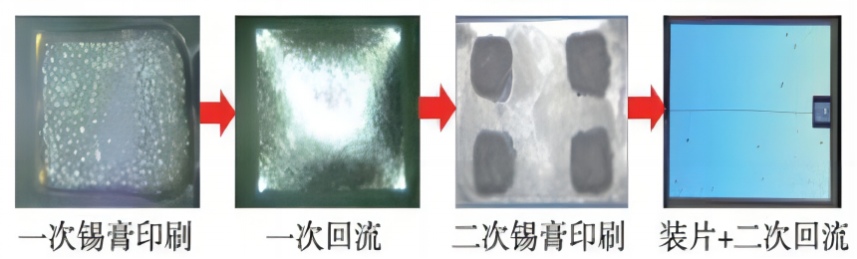
Al imprimir por primera vez pasta de soldadura de 75 μm de espesor, la mayor parte del gas de la soldadura sin la cubierta del chip se escapa de la superficie, y el espesor después del reflujo es de aproximadamente 50 μm. Tras completar el reflujo primario, se imprimen pequeños cuadrados en la superficie de la soldadura solidificada y enfriada (para reducir la cantidad de pasta de soldadura, reducir el derrame de gas y reducir o eliminar las salpicaduras de soldadura). Se aplica pasta de soldadura con un espesor de 50 μm (los resultados de la prueba anterior muestran que 100 μm es el mejor, por lo que el espesor de la impresión secundaria es de 100 μm. 50 μm = 50 μm). A continuación, se instala el chip y se vuelve a soldar durante 80 s. Tras la primera impresión y el reflujo, prácticamente no se observan agujeros en la soldadura, y la pasta de soldadura en la segunda impresión es pequeña, al igual que el orificio de soldadura, como se muestra en la Figura 14.
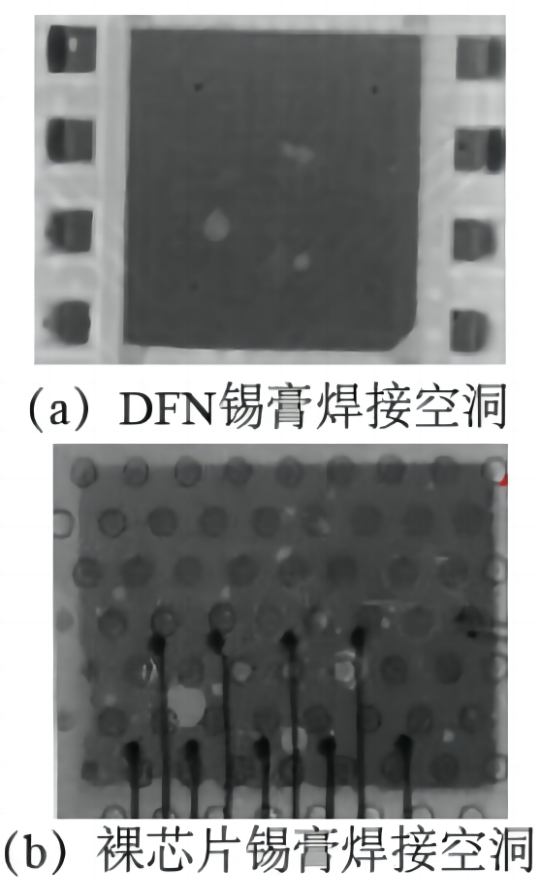
Después de dos impresiones de pasta de soldadura, dibujo hueco
4.3 Verificación del efecto de la cavidad de soldadura
Producción de 2000 productos (el espesor de la primera malla de acero de impresión es de 75 μm, el espesor de la segunda malla de acero de impresión es de 50 μm), otras condiciones sin cambios, medición aleatoria de 500 QFN y tasa de cavidad de soldadura de viruta, encontró que el nuevo proceso después del primer reflujo sin cavidad, después del segundo reflujo QFN La tasa máxima de cavidad de soldadura es del 4,8% y la tasa máxima de cavidad de soldadura de la viruta es del 4,1%. En comparación con el proceso de soldadura de impresión de pasta única original y el proceso optimizado DOE, la cavidad de soldadura se reduce significativamente, como se muestra en la Figura 15. No se encontraron grietas en la viruta después de las pruebas funcionales de todos los productos.

5 Resumen
La optimización de la cantidad de pasta de soldadura y el tiempo de reflujo permiten reducir el área de la cavidad de soldadura, pero la tasa de cavidad sigue siendo alta. El uso de dos técnicas de soldadura por reflujo con pasta de soldadura permite maximizar eficazmente la tasa de cavidad de soldadura. El área de soldadura del chip desnudo del circuito QFN puede ser de 4,4 mm x 4,1 mm y 3,0 mm x 2,3 mm, respectivamente, en la producción en masa. La tasa de cavidad de la soldadura por reflujo se controla por debajo del 5 %, lo que mejora la calidad y la fiabilidad de la soldadura por reflujo. La investigación de este artículo proporciona una referencia importante para mejorar el problema de la cavidad de soldadura en superficies de soldadura de gran superficie.
Hora de publicación: 05-jul-2023







